光與影的藝術:我的極紫外光刻技術研究之旅
作者:PoHusn Fang
從實驗室到國際舞台
「成功不是偶然,而是每一個不被看見的努力累積而成的。」當我站在2025年SPIE先進光刻與圖案化會議的演講台上,分享我們的研究成果「準相位移光罩用於高對比度極紫外成像」時,內心充滿了這樣的感觸。這段旅程不僅為我贏得了ASML最佳學生獎的殊榮,更讓我深刻體會到科學探索的真諦——持續的好奇與不懈的追求。
挑戰與創新
半導體製造的世界正面臨著前所未有的挑戰。摩爾定律的持續推進,使製程節點在短短十年內從28奈米迅速縮小到3奈米以下,這種驚人的微縮化趨勢已接近物理極限,亟需創新技術來突破瓶頸。
極紫外光刻技術(EUV)作為一項革命性技術,正推動著納米級裝置的高精度製造。然而,即使是這項前沿技術,仍面臨著諸多挑戰。我們的研究專注於解決傳統EUV相移光罩(PSM)所面臨的兩大關鍵問題:低影像對比度和明顯的光罩三維效應(Mask 3D effects)。
對許多非專業人士來說,這些術語可能顯得晦澀難懂。簡單來說,我們在尋找一種方法,讓製造晶片時的「印章」能夠製作出更清晰、更精細的圖案,就像是從普通印刷升級到高精度雷射雕刻,為下一代半導體技術鋪平道路。

圖1. 光刻技術的演進: 從早期的紫外光源到當代的極紫外光源,光刻技術波長不斷縮短(從436nm至13.5nm),實現了從微米級到納米級的製程節點躍進。這一技術演變使半導體產業得以持續遵循摩爾定律。
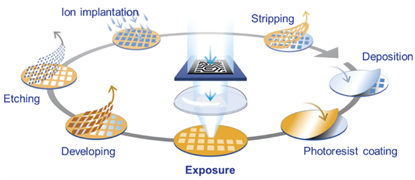
圖2. 光刻製程原理圖解: 這張示意圖展示了完整的光刻流程—光源發射的光線經過光學系統聚焦,通過光罩上的圖案,將精細結構投影到感光材料覆蓋的晶圓上,形成納米級電路圖案。EUV光刻的關鍵在於13.5nm波長的精確控制。
研究的突破
在實驗室夥伴張博凱的鼎力協作,余沛慈教授的悉心指導,以及台積電EBO AMMD團隊的全力支持下,我們成功開發出一種創新技術——基於鉬薄膜的「準相位移光罩」(Mo-based Quasi Phase Only Mask)。這項突破性技術不僅大幅提升了多種間距下的影像對比度,同時有效減輕了三維效應 (Mask 3D effects) 所帶來的負面影響。
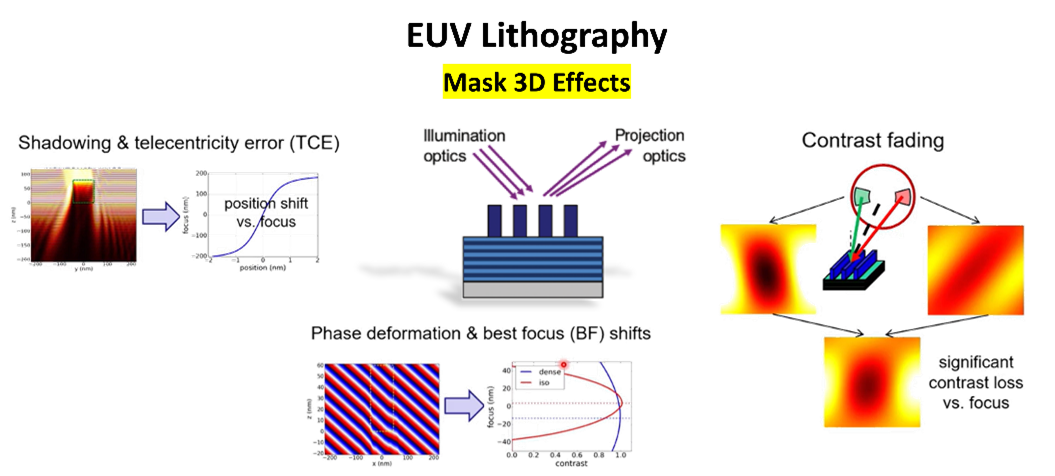
圖3. EUV光罩三維效應視覺化: 此圖說明了EUV光與多層光罩結構互動時產生的複雜物理現象。由於光波長與光罩特徵尺寸相當,入射光不再呈現理想的垂直傳播,而是產生散射、繞射和干涉等效應,這些「三維效應」會顯著影響最終成像品質。
我們的方法實現了使用簡化光源進行10奈米半間距的成像解析度,相比傳統基於TaBN的相移光罩展現出更寬廣的製程窗口。更具實用價值的是,鉬與現有的半導體製造工藝高度兼容,使這種方法能夠較為輕易地整合到目前的EUV生產線中,為產業提供了一條可行的技術路徑。
會議的精彩時刻
SPIE先進光刻與圖案化會議無疑是半導體光刻領域的年度盛事,匯聚了來自全球的頂尖人才,從學術研究者到產業先驅。今年的會議涵蓋了先進封裝、計算光刻、機器學習應用和量子計算等前沿話題,展現了科技發展的最新動向。
作為ASML最佳學生論文獎的候選人,我首先在大會主廳進行了5分鐘的精簡演講,向與會者介紹我們研究的核心概念和創新點。隨後是1.5小時的海報環節,在這個互動交流的平台上,我站在海報前向評委和與會者詳細闡述我們的研究成果並回答各種專業問題。
這個經歷既充滿挑戰又令人振奮。每個問題都是一次展示研究深度和廣度的機會,也是獲得寶貴專業反饋的珍貴時刻。我有幸與多位業界傳奇人物進行了深入交流,包括Fraunhofer研究所的Andreas Erdmann、IBM半導體的Nelson Felix以及被譽為光刻界教父的Chris Mack和Harry Levinson等知名專家。他們的見解和建議不僅肯定了我們的研究方向,也為未來的拓展提供了寶貴思路。
圖4. 光刻領域的標誌性人物: 從左至右:Andreas Erdmann(Fraunhofer研究所光刻模擬專家)、Nelson Felix(IBM半導體先進光刻負責人)、林本堅(台灣光刻技術先驅)以及Chris Mack(被譽為「光刻聖經」作者)。這四位專家的研究和貢獻塑造了當代光刻技術的發展方向。
圖5. 五分鐘快速演講現場: 在SPIE大會主廳進行的精簡演講環節,參賽者需在極短時間內闡述研究精華並突顯創新點。台上演講者正向來自全球的光刻專家和評委展示「準相位只光罩」技術的獨特優勢和應用前景。
圖6. 海報展示與專家互動: 海報展示是學術交流的重要環節,這張照片捕捉了研究者正在向評委和與會專家詳細解釋實驗數據和模擬結果的場景。透過面對面的討論,研究成果得到了更深入的審視與寶貴反饋。
獲獎的喜悅
頒獎典禮在演講和海報環節後的第二天隆重舉行。由於ASML最佳學生獎每年只有一位獲獎者,整個評選過程格外嚴格,獲獎難度可想而知。當主持人宣布我們的論文《準相位移光罩用於高對比度極紫外成像》獲得2025年ASML最佳學生獎時,那一刻的喜悅難以言表——所有的日夜攻關、反覆實驗和不懈追求都得到了最權威的肯定。
來自EUV光刻設備製造領域領導者ASML的認可,在我們的專業領域具有極其重要的意義,不僅是對過往工作的肯定,更是對未來研究方向的有力支持。
圖7. ASML最佳學生論文獎頒獎現場: 這一榮耀時刻標誌著研究成果獲得產業最高水平的認可。ASML作為全球領先的EUV光刻設備製造商,其年度最佳學生獎代表著對下一代光刻技術研究的權威肯定和對未來人才的支持。
研究背後的故事
這項成就絕非個人功勞,而是真正的團隊協作結晶。在與實驗室夥伴張博凱的密切合作中,在余沛慈教授的精闢指導下,再加上台積電EBO AMMD通過聯合開發計劃提供的關鍵支持,我們共同克服了一系列看似不可逾越的複雜挑戰。
EUV光刻系統的模擬極其複雜,初期的學習曲線異常陡峭。當模擬結果無法收斂,或理論預測與實驗數據存在偏差時,挫折感時常湧現。然而,正是這些困難和挑戰,促使我不斷深化對相關物理原理的理解,也鍛煉了我解決問題的能力和韌性。每一次失敗後的反思,每一個難題後的突破,都成為了寶貴的成長資產。
心得體會
「當你對某事感興趣時,就深入探索吧!」這句簡單的話語在我的研究旅程中展現出深刻的意義。面對EUV光刻技術的高度複雜性,我選擇了迎難而上而非退卻,結果發現隨著對技術理解的加深,我對這個領域的熱情也愈發強烈,形成了一個良性循環。
這段經歷讓我深刻體會到,機遇與挑戰總是相伴而行。通過直面挑戰,我們往往能開啟原本看似封閉的機會之門。這次會議不僅驗證了我們的技術成果,還提供了建立專業人脈的寶貴機會,讓我得以一窺行業當前關注的焦點與未來發展的方向。
未來展望
在會議期間收到的專業反饋已經激發了我們對現有方法進一步優化的新思路。與業界專家建立的聯繫也開啟了關於潛在應用場景和深度合作可能性的討論,為研究的實際轉化鋪平了道路。
對於那些正考慮在相關領域深耕的學生和研究人員,我想分享這個建議:不要迴避複雜問題,尤其是在產業亟需突破的技術瓶頸領域。學術研究與工業應用的交匯處,往往是最具突破性和影響力的創新發生之地。在展示你的研究成果時,不僅要關注技術細節,更要有意識地傳達你的研究對產業和社會的更廣泛影響和潛在應用價值。
感謝與致敬
這一路走來,沒有余沛慈教授的精闢指導和專業引領,這一成就將無法實現。他的真知灼見和全程支持,是這項研究得以成功的關鍵基石。我也衷心感謝我的研究夥伴張博凱,正是他的協作精神和專業投入,使這項具有挑戰性的研究得以順利進行。特別感謝台積電EBO AMMD團隊通過聯合開發計劃提供的技術支持和產業視角,這為我們的研究注入了實用性和前瞻性的雙重價值。
在繼續我的學術和專業旅程時,我不僅帶著通過這項研究獲得的專業知識,還有對毅力、團隊協作以及創新思維在推動科技進步中不可或缺作用的深刻體悟。半導體技術的發展永無止境,而我們的探索也將持續前行。
